当前位置:首页 » 常见问题 » LTCC陶瓷基板叠层后背印效果
LTCC陶瓷基板叠层后背印效果
在布线层数较多的低温共烧陶瓷基板中,通常会存在单层瓷片的双面均需要印刷的情况。为了解决这种双面大面积印刷带来的变形、对位偏移、开裂等问题,采用层压后再二次印刷背面金属层的方法,研究了二次印刷、二次等静压工艺对成型后瓷体和金属层的影响,通过膜层厚度、收缩率、翘曲度、膜层附着力、可焊性等指标对此工艺进行了评价。结果显示,改进后的二次印刷成型工艺能有效提高此类具有单层双面布图的低温共烧陶瓷基板的成品率,制备的成品电路基板具有优异的可装配性和可靠性。

低温共烧陶瓷(LTCC)基板作为陶瓷封装基板的一种,具有优良的电学、热学、机械和加工性能,可以满足低频、数字、射频和微波器件多芯片组装的技术要求,现已广泛应用于各类电子产品中。
相对于其他类型的互联电路基板,LTCC基板最大的特点是基板布线层数多、布线设计自由度高,可在不增加工艺流程的前提下实现任意层的直接互联。为充分利用LTCC基板这种高布线密度的特点,现有的LTCC电路设计中常会出现单层介质正反两面均需要印刷电路图形的情况。
由于常用的LTCC生瓷片单层厚度仅为127 μm左右,且生瓷片由玻璃、陶瓷粉体与有机载体混合而成,其自身强度较低。在进行双面印刷后,一方面印刷导体浆料会部分渗透进入瓷体,造成瓷体强度进一步降低,从而导致瓷片开裂、破损等问题.
另一方面,双面印刷后的烘干工艺中,印刷区域和空白瓷区域会由于材料物性差异导致出现瓷片变形的情况,进而导致烧结时出现翘曲、收缩不一致等更严重的问题。特别是在微波射频电路基板中,由于存在大面积接地印刷层和大面积焊接印刷层,印刷浆料的量更大,这种由双面印刷带来的缺陷更明显。
这些缺陷将严重影响LTCC基板的可靠性,尤其是在LTCC基板使用过程中,由于应力分配不均、热膨胀系数失配等因素将造成微裂纹扩展、焊盘脱落等更严重的故障,为LTCC的应用带来了极大的挑战。
一,工艺设计及实验方法
1.1 材料选择
试验选用的LTCC材料体系为常用的Ferro A6M,内层印刷选用FX30-025型导体浆料,背面二次印刷的焊接浆料选用CN36-020型导体浆料。
试验样品设计单片电路尺寸为25 mm×35 mm, 介质层数12层,厚度1.15 mm。在布线设计上,最后一层生瓷片(第12层)的正面使用FX30-025型导体浆料印刷大面积网格地,背面Bottom层用CN36-020型导体浆料印刷大面积的焊接层。
1.2 工艺设计
在常规的LTCC工艺中,先完成每层生瓷片的所有单层工艺(包括冲孔、填孔、丝印),然后将这些层堆叠起来,再经过等静压即可获得生坯料,最后通过排胶和烧结获得成品的LTCC熟瓷基板。常规LTCC工艺流程图如图1所示。本文改进的工艺方案中,单层工艺中只印刷最后一层生瓷片正面的图形,在等静压之后再进行最后一层生瓷背面(Bottom层)大面积的印刷,然后进行二次等静压、烧结获得成品基板,工艺流程图2所示。
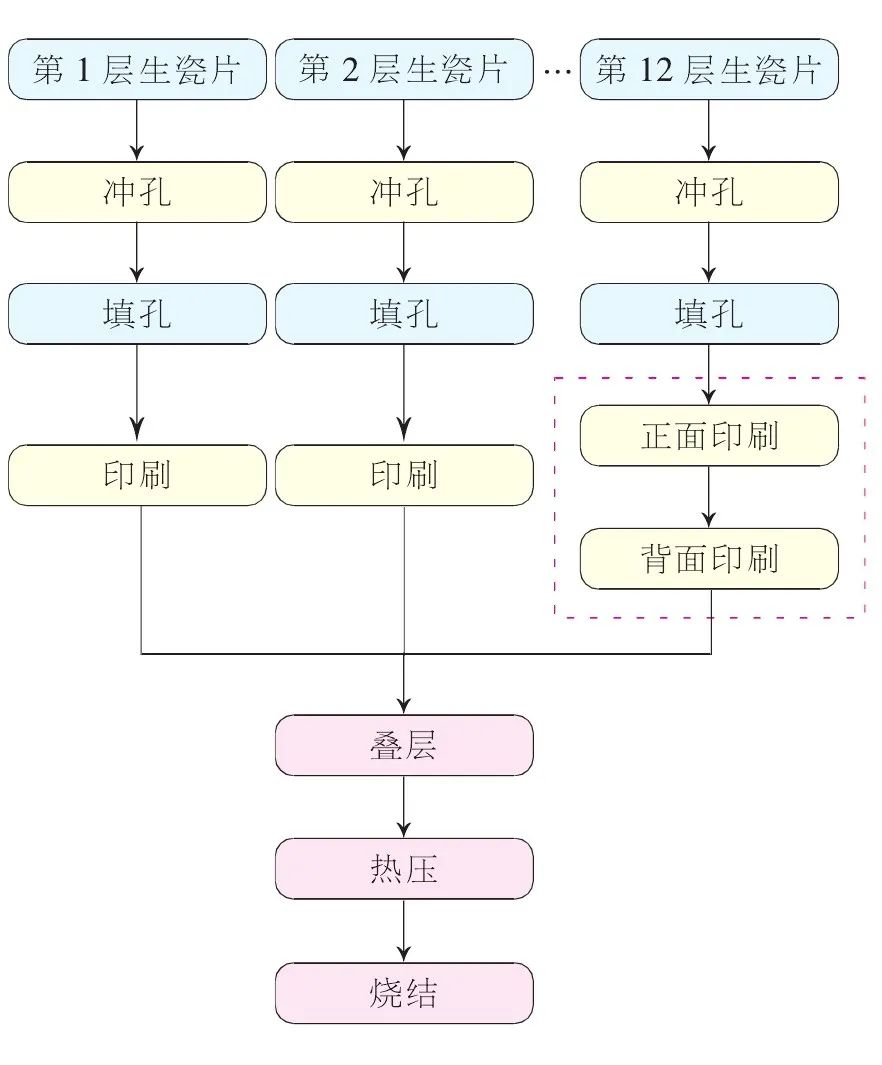
图1 常规工艺流程设计图
分别使用常规工艺和改进工艺各制备一版LTCC基板进行对比,其中常规工艺(图1)记为工艺方法A,此方法第12层生瓷片正面印刷和背面印刷连续进行,如图1中虚线框所示;而改进的二次印刷工艺记为工艺方法B(图2),此方法第12层生瓷片先印刷正面,叠层等静压之后再进行背面印刷。
由于改进的工艺中需要对基板生坯进行两次等静压,而后印刷以及等静压工艺会直接影响到基板烧成后的膜层厚度、成膜形貌、收缩、膜层可焊性等[11,12,13,14]。因此,本文重点研究两种工艺对基板成型后膜层的影响。

图2 LTCC二次印刷工艺流程设计图
1.3 分析方法
使用ZEISS sigma型扫描电镜对生瓷片表面微观形貌进行了观察;对烧成后的熟瓷样品剖切制样,使用扫描电镜对金属膜层厚度进行测量;采用XP-1型台阶仪对烧结后基板的翘曲度进行表征,对比了两种工艺对基板翘曲的影响;采用E43-104型电子万能试验机对膜层附着力进行测量;采用CT-52G型锡炉对可焊性进行定性测量。
结果分析
2.1 二次印刷对膜层形貌及厚度的影响
采用两种工艺方法制备的LTCC样品背面大面积焊接金属层的显微图片如图3所示,其中图3a为工艺方法A获得的样品表面显微图片,图3b为工艺方法B的样品表面显微图片。对比发现改进后的再印刷方法获得的样品表面孔隙率与常规方法的表面孔隙率无明显差异,其形貌均为多孔结构,这些孔隙是由于导体浆料中有机成分烧除后所形成的。
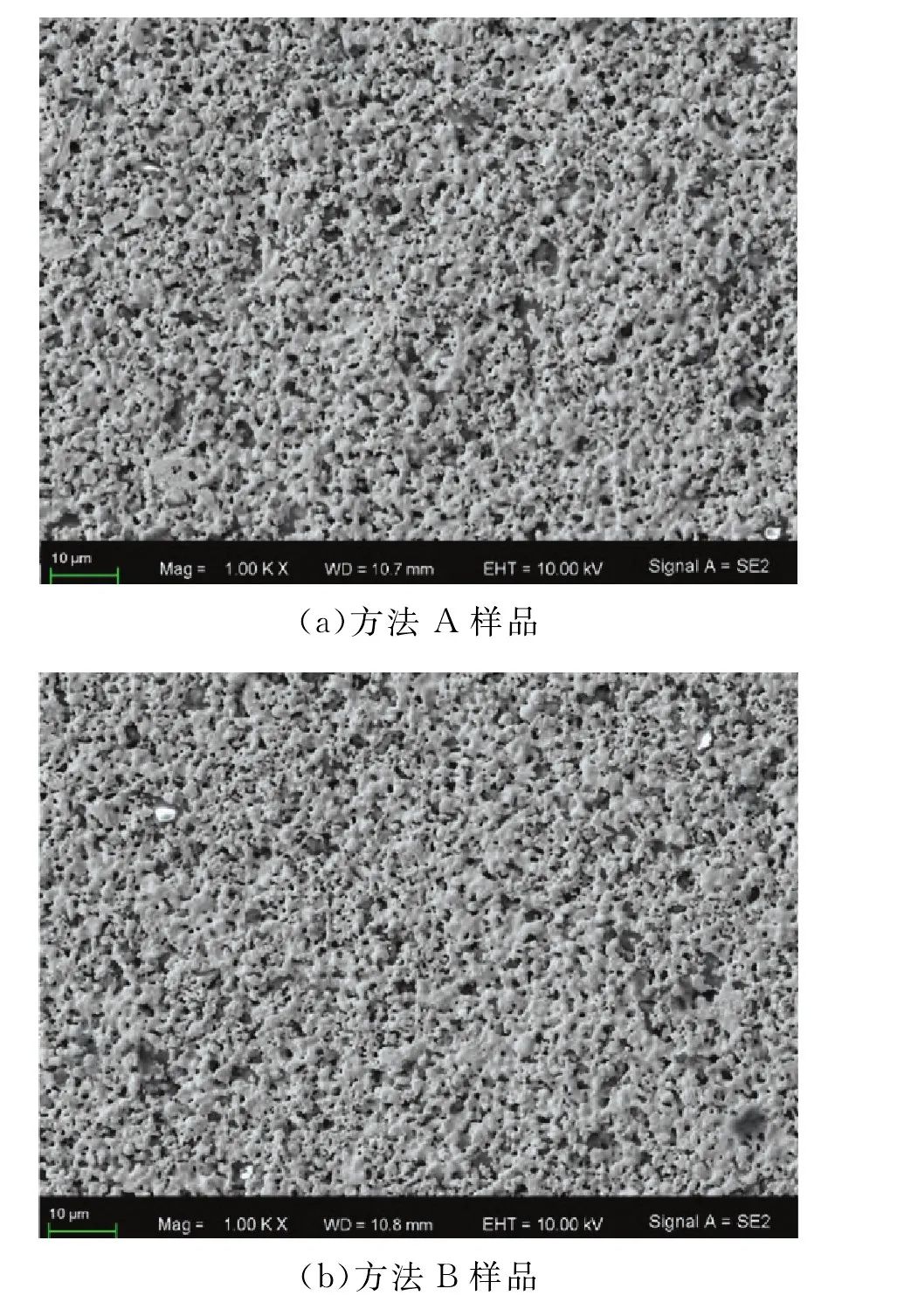
图3 背面大面积焊接层的表面显微图片对比
2.1 二次印刷对膜层形貌及厚度的影响
采用两种工艺方法制备的LTCC样品背面大面积焊接金属层的显微图片如图3所示,其中图3a为工艺方法A获得的样品表面显微图片,图3b为工艺方法B的样品表面显微图片。对比发现改进后的再印刷方法获得的样品表面孔隙率与常规方法的表面孔隙率无明显差异,其形貌均为多孔结构,这些孔隙是由于导体浆料中有机成分烧除后所形成的。
为了进一步对比表面膜层情况,采用剖切的方法获得了背面大面积焊接金属层的剖面显微图片,如图4所示,其中图4a为工艺方法A样品剖面显微图片 ,图4b为工艺方法B样品剖面显微图片。
通过对比发现,采用两种工艺方法获得的大面积层的剖切面形貌无明显差异,且烧成厚度测量值均大于指标要求的15 μm, 能满足焊接使用要求。两种样品的膜厚差异约为1 μm。由于两种方法在印刷工序中使用了同样的网版和印刷参数,仅在背面的导体层印刷顺序上及等静压上有差别,结果表明这种工艺差别不会对膜层的形貌及厚度等特征产生影响,采用二次印刷方法可以获得与常规工艺特征相同的膜层。

图4 背面大面积焊接层的剖面显微图片对比
2.2 二次印刷对基板收缩率的影响
LTCC基板的收缩主要受到介质中玻璃/陶瓷粉料特性以及生片特性的影响。而加工工艺中对基板收缩影响较大的工序包括等静压、烧结。如图1、图2所示,两种工艺中的等静压工艺存在差异。
为了研究工艺变化对收缩率的影响,分别采用工艺方法A和B各制备3件样品,编号1JHJ~6JHJ,对比了水平方向(X\\Y)和厚度方向(Z)的收缩率。其中工艺方法A采用常规等静压工艺参数:压力3 000 PSI,温度70 ℃,保压15 min; 工艺方法B中一次等静压压力1 000 PSI,温度70 ℃,保压8 min; 工艺方法B中二次等静压压力3 000 PSI,温度70 ℃,保压12 min。两种工艺方法收缩率对比见表1。
从表1中可以看出常规工艺方法A获得样品的水平方向收缩率均值分别为15.62%(X方向)、15.58%(Y方向),而工艺方法B收缩率X方向15.47%、Y方向15.53%,差异在0.2%以内;同时,两种工艺得到的厚度方向的收缩率分别为25.92%(方法A)、26.07%(方法B),其差值同样在0.2%范围以内。
这种差异与LTCC原材料本身带来的收缩率差异范围相当。两种工艺下LTCC基板的收缩率偏差一致性满足X/Y方向:15.5±0.3%,Z方向:26.0±0.3%的指标要求。
因此,两种工艺获得的基板收缩率基本一致,二次印刷工艺不会对收缩产生影响。
表1 两种工艺方法收缩率对比情况

2.3 二次印刷对翘曲度的影响
为了研究二次印刷工艺对基板共烧结匹配性的影响,对比了两种工艺方法制备的基板的翘曲度,如图5所示,其中图5a为工艺方法A样品翘曲度曲线 ,图5b为工艺方法B样品翘曲度曲线。对比曲线可以看出两种样品的翘曲度绝对值均小于30 μm, 翘曲度值<1.5 μm/mm(0.15%),两种基板的翘曲度无明显差异,均满足常规LTCC基板的翘曲度≤0.3%的指标要求。此结果表明二次印刷并不会影响金属导体与瓷体的共烧匹配性。
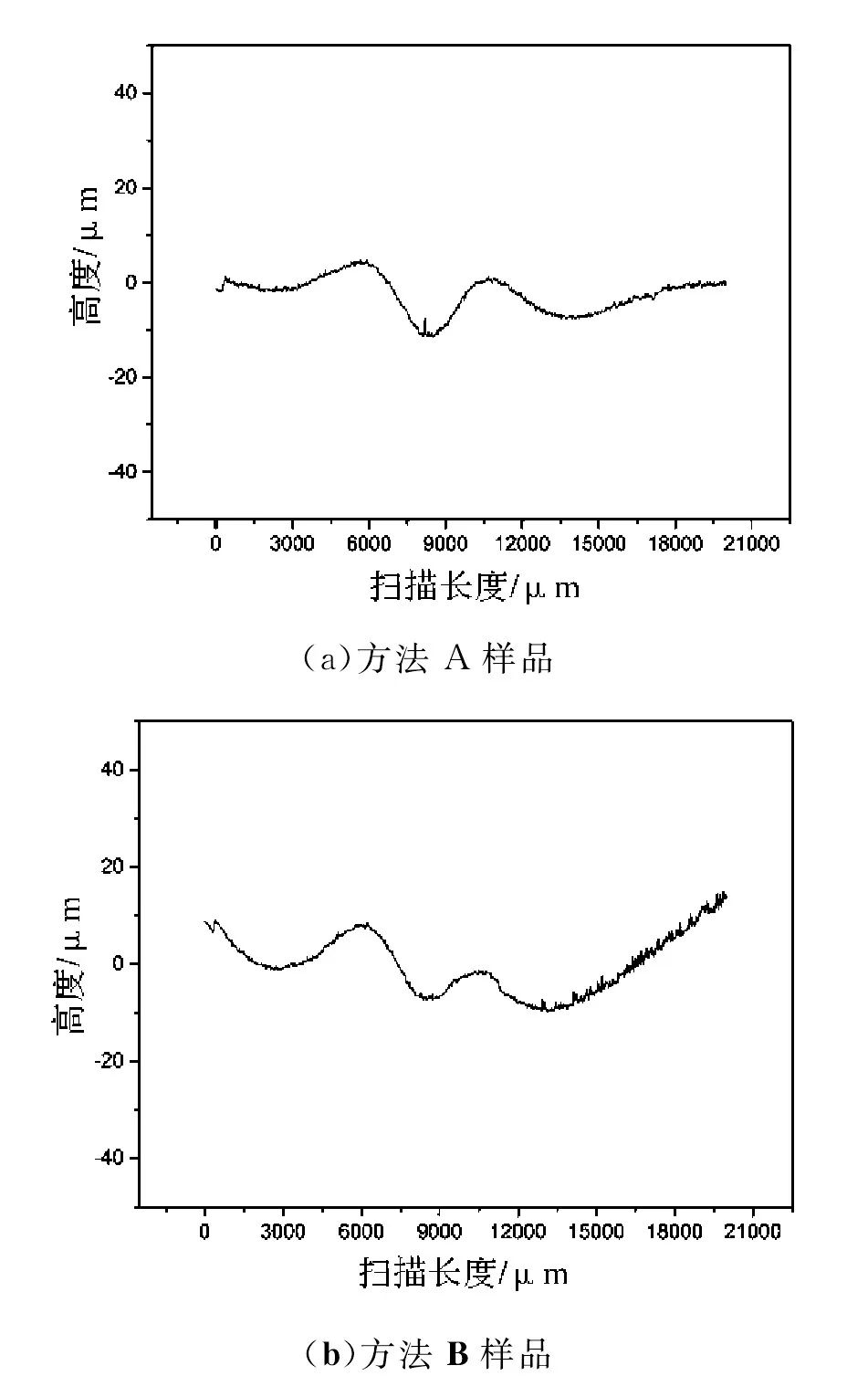
2.4 二次印刷对膜层附着力的影响
在LTCC基板共烧时,导体层与介质陶瓷间的膜层附着是由于陶瓷中的玻璃成分渗透进导体形成机械锚固。通常为了提高这种锚固力,在导体中同步加入陶瓷粉料,以达到更好的锚固作用。为了检验二次印刷后的膜层附着强度,参考IPC-TM-650 2.4.21.1c标准进行试验,在LTCC生坯背面同步印刷了面积2.43 mm2的焊盘进行拉脱测试,测试结果如下表2所示。
从图中可以看出两种样品的拉脱强度均大于15 MPa, 远高于装配要求的4.6 MPa, 满足基板附着力性能指标要求。结果表明再印刷工艺获得的膜层与常规工艺的附着强度相当,此工艺不影响金属膜层与瓷体之间的渗透与相互锚固,膜层可靠稳定。
表2 两种工艺方法膜层附着力值

2.5 二次印刷对可焊性的影响
基板背面大面积的金属层膜层一般用于装配焊接,膜层的可焊性对装配质量的好坏至关重要,而影响膜层可焊性的因素包括膜层表面活性、表面吸湿性、污染物、玻璃相占比等。因此,为了研究再印刷对膜层的影响,参考GJB548B-2005中方法2003,对两种工艺方法获得的样品进行了可焊性浸焊测试对比,焊料温度245±5 ℃。
图6为两种样品背面大面积焊接层的焊接润湿性对比,其中图6a为方法A样品的可焊性测试图片,图6b为方法B样品的可焊性测试图片。从图中可以看出图6a润湿性良好仅有少数针孔,这些润湿针孔未见AuPtPd印刷层露出,可能是由焊料中的杂质或污染造成;图6b可以看到基板润湿性极好,仅有少量的润湿针孔,且上锡厚度较厚。
因此,两种样品的润湿面积满足GJB548B对可焊性润湿性面积大于95%的要求,可见再印刷工艺未对基板可焊性产生影响,能满足后续装配工艺的需求。
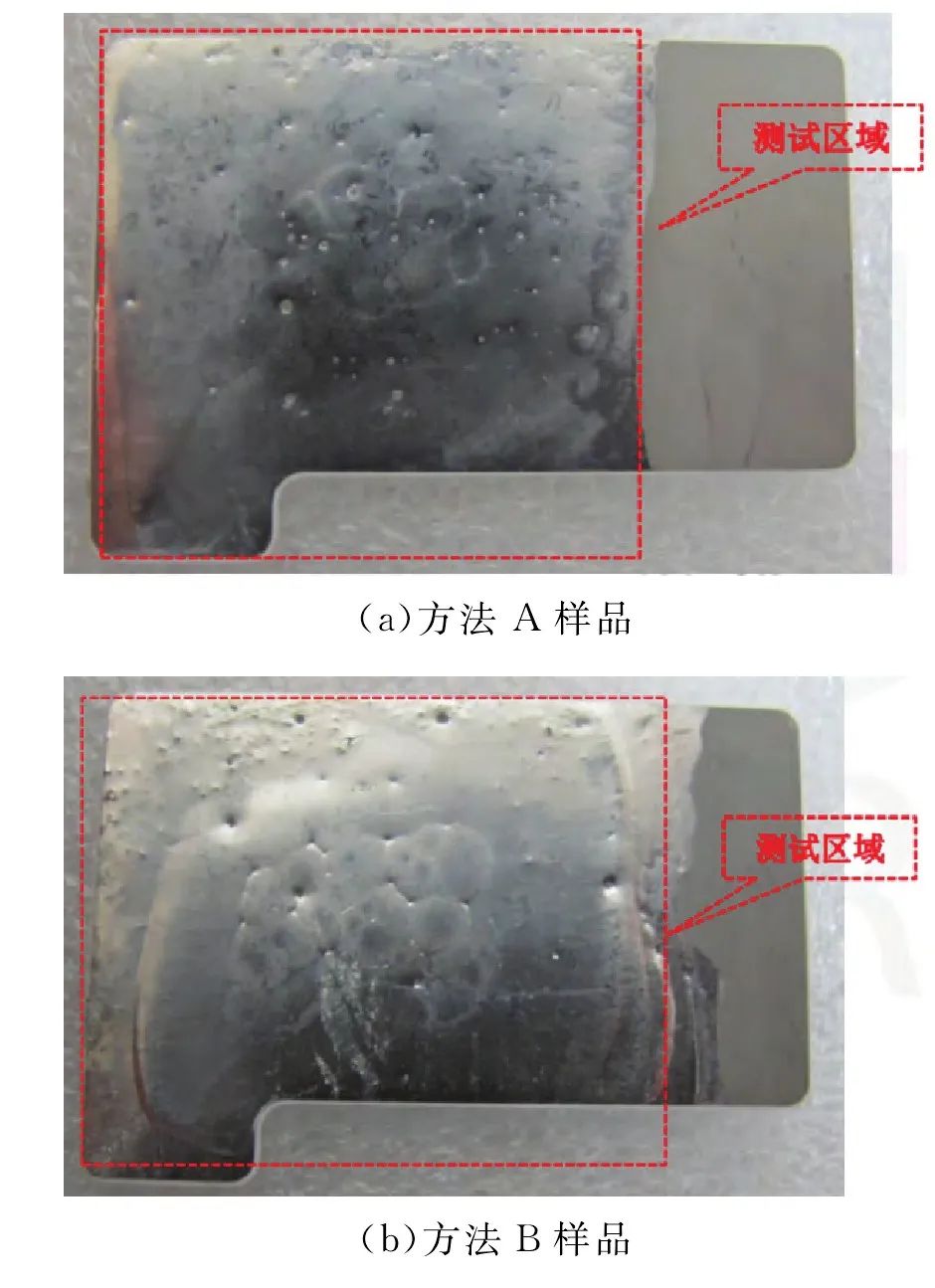
图6 背面大面积焊接层的可焊性测试图片
2.6 二次印刷对成品率的影响
为了进一步对比二次印刷与原有工艺在成品率上的区别,采用两种工艺各制备两个生产批次的样品,单批次为10版,拼版数量为6块/版。两种工艺的缺陷情况对比情况见表3。
表3 两种工艺缺陷情况对比

从表3中可以看出,此类双面印刷采用工艺方法A出现的不可修复的缺陷主要包括印刷图形边缘整体开裂以及腔体拐角的延伸开裂,其缺陷比例高达5%;而工艺方法B只印刷单面然后压合,此时已形成具有较高强度的生坯,因此未出现开裂现象。
此外,工艺方法A出现的可修复缺陷主要包括印刷外溢,工艺方法B等静压后生坯平整性相比方法A要好,因此未出现外溢情况。第四种缺陷是由生瓷变形造成的对位偏移,此类缺陷在工艺方法A中出现比例极高。
图7所示为两种方法的叠层孔位剖面图,其中图7a为工艺方法A中出现的对位偏移情况,从图中可以看出,导通孔从上往下剖切后,顶层孔已无法看到填孔浆料,表面顶层的通孔与下层出现了严重偏差,该偏移一般在20~40 μm, 当偏移达到150 μm以上时将出现断路造成基板报废。
图7b为正常对位情况,从图中可以看到剖面孔位完整,表明叠层对位效果较好。这种缺陷主要是因为双面印刷需要提前去掉背膜,从而造成生瓷出现自由伸缩,同时由于双面印刷的金属浆料的含量过高,其渗透进瓷片后同样会造成瓷片的伸缩变形。出现第四种缺陷后需要采用手工对位的方式来进行叠片,此时多层互联导通孔会出现明显的对位偏移,当偏移距离超过孔径时就会出现断路;即使偏移未超过孔径,这种局部搭接也是不可靠的连接,在使用中容易出现故障。
从上述两种工艺方法的缺陷对比可以看出,采用叠压后再二次印刷的方法,能有效避免常规工艺方法中出现的开裂、外溢和对位偏移问题,显著提升了此类双面布图LTCC基板的成品率。
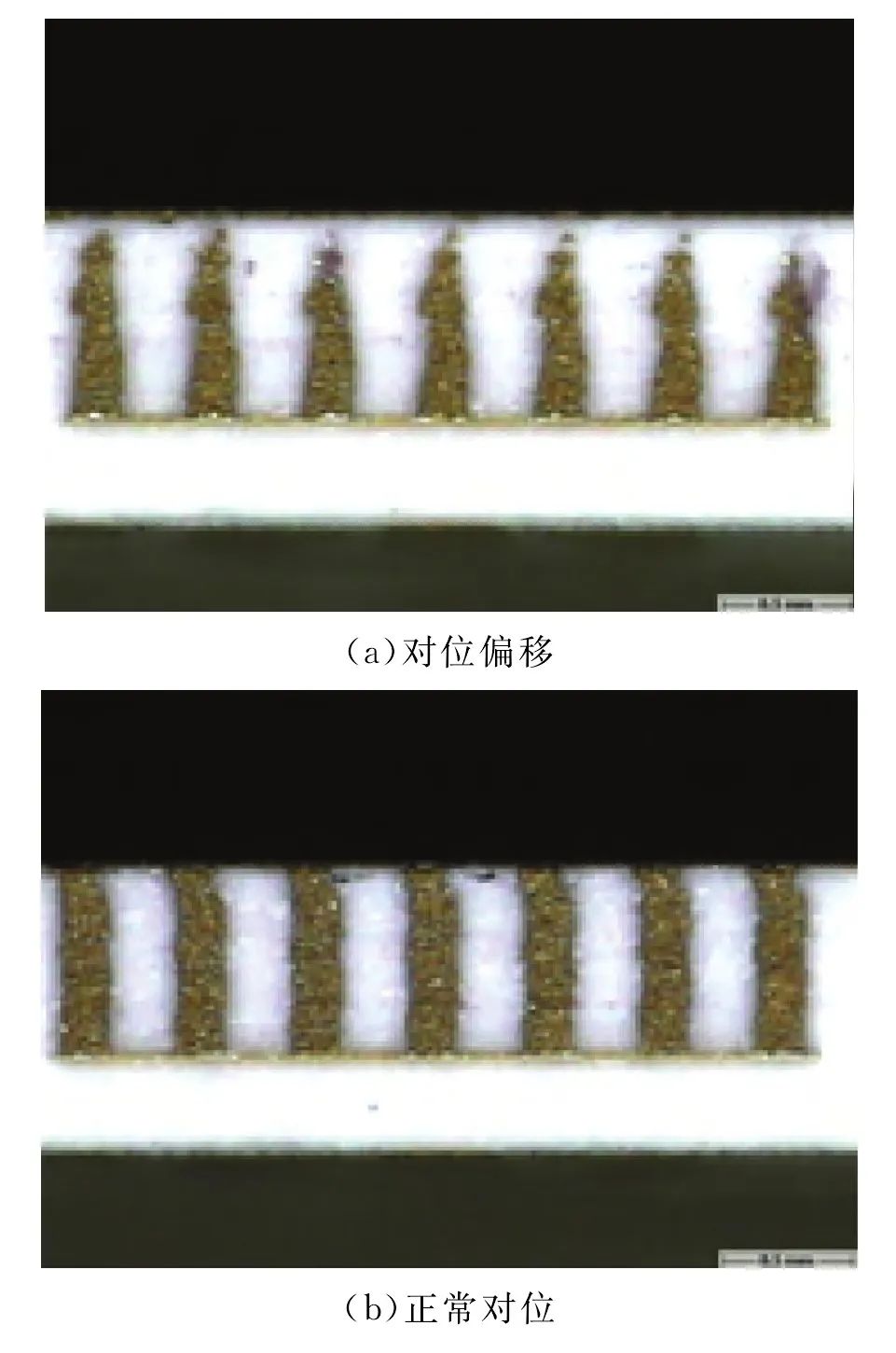
结论
通过低温共烧陶瓷生坯二次印刷工艺,可以有效杜绝双面印刷带来的瓷片开裂、断路等问题,显著提高了此类带有单层双面布图LTCC基板的成品率,且不会影响金属层的成膜质量和膜层形貌。
同时,在改进后的二次印刷成型工艺中,基板需要进行二次印刷和等静压,本文通过试验对改进前后两种基板的翘曲度、膜层附着力、可焊性等指标进行了对比,结果表明改进后的二次印刷和等静压工艺不会对基板收缩率、翘曲度和膜层附着力产生影响。
同时制备的成品电路基板具有优异的可焊性,其整体可装配性和可靠性均满足LTCC基板的应用需求。金瑞欣特种电路可以加工LTCC陶瓷基板,品质可靠,值得信赖!
内容来源:
[1] 今中佳彦.多层低温共烧陶瓷技术[M].詹欣祥,等译.北京:科学出版社,2010.
[2] 周德俭.电子制造中的电气互联技术[M].北京:电子工业出版社,2010.
[3] LITUNOV S N,YURKOV V Y.Research of paste transition to substrate in LTCC-technology[J].Journal of Physics:Conference Series,2018,944(1):012075.
[4] 郝鹏飞,景灏.LTCC印刷工艺研究[J].山西电子技术,2020(3):82-84.
[5] JASINSKA L,MALECHA K,SZOSTAK K,etal.Impact of process parameters on printing resolution and dielectric properties of LTCC substrate[J].Microelectronics International 2019,36(3):114-119.
[6] 卓良明.LTCC基板缺陷分析及改善对策[J].电子元件与材料,2019,38(6):107-110.
[7] 徐美娟,冯晓晶,贾旭洲,等.LTCC基板铂钯金膜层铅锡焊接可靠性分析[J].电子工艺技术,2021,42(5):289-291,298.
[8] KO M,LYOO S,CHOI Y,et al.Effect of crystallization on Adhesion Strength of External Electrode in LTCC.MRS Online Proceedings Library Archive,2006,968(1):11.
[9] 寇凌霄.低温共烧陶瓷(LTCC)烧结收缩率的控制[J].微处理机,2017,38(5):32-34;
[10] 贾耀平.LTCC基板关键工艺问题解决方案.中国科技信息,2019,(15):84-86.
[11] KHOONG L E,TAN Y M,LAM Y C.Overview on fabrication of three-dimensional structures in multi-layer ceramic substrate[J].Journal of the European Ceramic Society.2010,30(10):1973-1987.
[12] HORVATH E,HENA P G.Mechanical characterization of glass-ceramics substrate with embedded microstructure[J].Journal of Materials Science:Materials in Electronics,2012,23,(12):2123-2129.
[13] QIAN S,LIV F,MA M,etal.Mechanical strength enhancement of low temperature co-fired multilayer ceramic substrates by introducing residual stress[J].Ceramics International.2019,45(8):10982-10990.
[14] 陈宁.LTCC丝网印刷细微线条技术研究.电子工艺技术,2019,40(2):89-93.
[15] 张孔.LTCC高精度共烧电阻的制备工艺研究.电子工艺技术,2017,38(2):84-88.
[16] 崔鲁婧,张兆华.基于LTCC厚薄膜混合基板的Ka波段T/R组件封装技术[J].现代雷达,2017,39(9):86-89.
[17] 张婷.基于LTCC的微波多芯片组件立体组装工艺技术[J].空间电子技术,2015,12(4):75-79.

通过公司研发团队的不懈努力,现已成功研发微小孔板、高精密板、难度板、微型化板、围坝板等,具备DPC、DBC、HTCC、LTCC等多种陶瓷生产技术,以便为更多需求的客户服务,开拓列广泛的市场。
© 2018 深圳市金瑞欣特种电路技术有限公司版权所有 技术支持:深度网