当前位置:首页 » 行业动态 » 陶瓷薄膜电路在T/R组件中应用优势
陶瓷薄膜电路板精密度高、集成度高,散热性和绝缘性都很好,可以制造精度比较高(薄膜线宽和线间距较小),可实现小孔金属化,可集成电阻、电容、电感、空气桥等无源元件,并且根据需要,薄膜电路可以方便地采用介质制造多层电路。因此陶瓷薄膜电路在T/R组件中广泛应用。今天小编来分享一下为何陶瓷薄膜电路如此受欢迎呢?
薄膜多层陶瓷电路是指采用真空蒸发、溅射、电镀等薄膜工艺以及湿法刻蚀和干法刻蚀(反应离子刻蚀、等离子刻蚀、激光刻蚀)等图形形成技术,在抛光的基板(陶瓷、硅、玻璃等材料)上制作导体(Cu或Au等)布线与绝缘介质膜(PI或BCB等)相互交叠的多层互连结构。
薄膜陶瓷多层电路技术,由于具有互连密度高、集成度高、可以制造高功率电路、整个封装结构具有系统级功能等突出特点,在微波领域的应用很有竞争力,特别是在机载、星载或航天领域中,其体积小、重量轻、可靠性高的特点更加突出,是一种非常有潜力的微波电路模块(低噪声放大器、滤波器、移相器等)、甚至需求量越来越大的T/R组件基板制造技术。
(1)布线密度高,体积可以很小、重量很轻;
(2)集成度高,可以埋置电阻、电感、电容等无源器件以及有源芯片;
(3)高频特性好,可用于微波及毫米波领域;
(4)承受功率密度高,可选用高导热的金属、金刚石、陶瓷或铝炭化硅复合材料等作基板,制造高密度高功率多层基板。
(1)工艺采用串形方式,成品率相对低,制造成本高;
(2)制造层数受限制。
薄膜陶瓷多层电路技术由于具有明显的优点和缺点,因此在制造T/R组件的选择上,有两种方案。
第一,可以采用薄膜技术在陶瓷基板或金属基板上直接制造T/R组件(4~5),发挥薄膜高精度、高集成度、高功率的性能,这种方法成本较高;
第二,将薄膜技术和其他多层电路技术(如厚膜技术、HTCC、LTCC等)结合起来(6-8),制造T/R组件,扬长避短,既发挥其他基板容易实现多层的特点,从而克服薄膜技术本身制造层数不足的缺点,又能发挥薄膜技术本身的高精度、高性能特长。
T/R组件是雷达的核心,一个雷达有成千上万个T/R组件,T/R组件不论其使用频率是否相同,也不论其使用场合是否相同,其基本构成是相同的,主要是由功率放大器、驱动放大器、T/R开关、移相器、限幅器、低噪声放大器、环流器、逻辑控制电路等组成。这些基本构成,在工艺实现时,部分可以直接做在电路板上,如微带传输线、开关、耦合器、滤波器等,部分采用外贴芯片(如功放、驱放等)、电容、环流器等来实现。因此,从使用功能和结构上,T/R组件实际上可以看作是一种具有收发功能的微波多芯片模块。
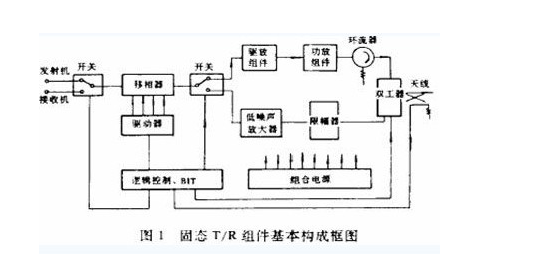
受雷达波束栅瓣效应(相邻两个辐射单元的中心距小于工作波长的一半)以及重量、成本等限制,T/R组件的小型化、集成化、轻量化将是其发展趋势。为了满足其性能要求,采用低温共烧来研制和生产T/R组件成为必然选择。如下图所示。

RCA实验室在1985年报道了在高导热陶瓷BeO基板上采用薄膜工艺制造的T/R组件(3),尺寸为175px×225px×40px,工作频率16.0~16.5GHz,峰值功率3.9~4.4 W,电压调谐范围2.5~2.9,噪声系数5dB。
Martin Marietta实验室,1995年首次报道了采用薄膜技术制造了频率高达94GHz 的W波段的8单元T/R组件(4),如图3所示。组件的尺寸16.5mm×707.5px×1.8 cm,最大增益47.8 dB。主要工艺为:先在0.5毫米厚的钼基片上,采用铜导体和聚酰亚胺的薄膜多层工艺制造直流和控制信号主板,然后在0.125mm厚的低损耗Al2O3陶瓷板上用薄膜工艺制造RF传输线,最后将RF部分和芯片、电容等装配在低频主板上。
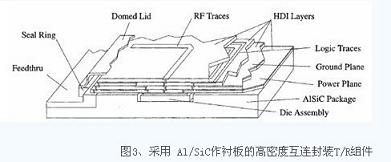
1992年,通用公司报导了采用薄膜和厚膜混合工艺研制的宽带S/C波段T/R组件(8)(3.0~6.0GHz),尺寸只有3.3英寸×1.17英寸,S波段输出功率21W, C波段输出功率19W,接收增益30~38 dB。其结构示意图如图4所示,在同一块氧化铝陶瓷基板(厚0.635mm)上,正面采用薄膜技术做微带电路,背面采用厚膜技术做4层布线,正面薄膜电路和背面厚膜电路之间的互连采用激光打孔的方法实现,芯片和器件埋在陶瓷板孔内。
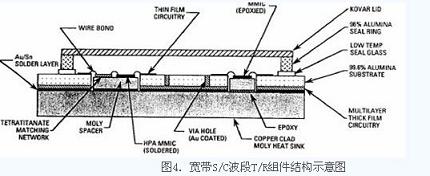
在半导体硅材料上,采用薄膜多层技术制造T/R组件的优点是可以和半导体技术兼容,可以集成有源芯片、无源器件,组件可以做的很小、并且能够大批量生产;缺点是由于硅材料导热率低,在需要高功率或高Q值的场合,高导热的氮化铝、氧化铍陶瓷更有优势。图5是美国辛西纳底大学研制的薄膜多层发射模块示意图,它是在硅基片上,用Dupont公司的聚酰亚胺做介质(每层介质厚度9~15μm),用Ti-Au-Ti或Cr-Au-Cr做导带(Au厚度2~3μm),制作的4层金属、3层介质的多层互连结构。
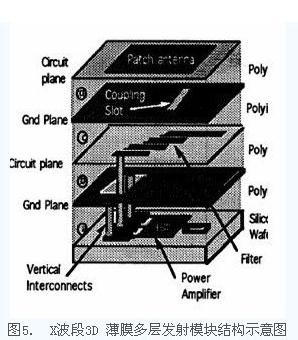
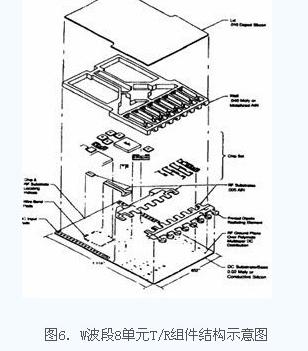
GE 和 Lockheed Martin 等公司合作开发的基于HTCC基板的薄膜多层电路的T/R组件(7),如图7所示。预先将HTCC基板开槽并金属化,将功率芯片贴装预槽内,使之与基板表面持平,然后在其上实施HDI工艺。
采用 HTCC做T/R组件的基板,是充分利用了高温共烧陶瓷(HTCC)和薄膜多层的优点,而又避开其不足。HTCC的优点是热导率高、易实现多层;其缺点是由于采用的电阻率高的Mo、W等浆料制作导带,微波损耗较大。薄膜多层互连技术的优点:线条精度高,采用Cu、Au等电阻率低的材料作导带,微波损耗小;其缺点是耐功率不足、多层成本高。基于 HTCC的薄膜多层互连技术可以将电源线、地层、信号线布在HTCC中, 以满足耐功率需要并减少薄膜多层层数。功率芯片可以通过焊接的方式贴在HTCC的凹腔中,有利于散热。微带线及芯片精细互连线可以作在少数几层HDI层中,满足微波性能的需要。

Reinhardt Microtech公司和Micro Systems Engineering 公司合作开发了一种可用于X波段T/R组件的精细混合(Finebrid)集成技术,这种技术是将LTCC和薄膜技术集成在一起,在采用杜邦951或943生瓷制造的LTCC板上,不用抛光等处理,直接制造精细薄膜电路图形,结构示意图见图8。利用LTCC容易实现多层的特点,把直流电源线、控制信号线做在不同的层上,还可埋置电阻、电容等无源器件。选用杜邦951或943生瓷,是因为制成的LTCC损耗比较小。利用薄膜的高精度特点,把无源器件(如Lange耦合器、滤波器、电阻网络、衰减器、功率分配器等)集成在LTCC表面。实用中薄膜图形典型的线条及间距20微米,膜层厚度5微米;NiCr层充当电阻层和粘附层。从结构图上可以看出,芯片安装在LTCC表面的凹腔内,可以减小键合长度及关联电感,芯片热量可通过背面的散热通孔柱传到下面的热沉上,可克服LTCC热导率低的缺点。经可靠性测试,在LTCC表面实施薄膜工艺与在氧化铝陶瓷上的可靠性相当。
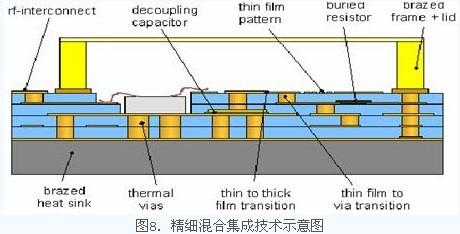
与传统的在陶瓷基板实施薄膜工艺相比,薄膜技术在T/R组件的应用有两个明显的新的趋势,一是,在高导热的金属、合金、复合材料( Al/SiC)上采用多层薄膜工艺,制造T/R组件,提高了组件耐功率性能,并且利于封装;还可根据设计需要把芯片贴装在表面的凹腔内,减短了金丝键合的长度或者不用键合,减小了或克服了寄生效应,改善组件性能;二是在其他多层基板(如HTCC或LTCC)上,实施薄膜工艺制造T/R组件,充分发挥HTCC或LTCC易实现多层及埋置无源器件的优点以及薄膜工艺高精度、低损耗的优点,对减小T/R组件基板尺寸、改善组件的电性能和热性能有重要意义。
以上内容大部分来自AET网站

通过公司研发团队的不懈努力,现已成功研发微小孔板、高精密板、难度板、微型化板、围坝板等,具备DPC、DBC、HTCC、LTCC等多种陶瓷生产技术,以便为更多需求的客户服务,开拓列广泛的市场。
© 2018 深圳市金瑞欣特种电路技术有限公司版权所有 技术支持:深度网