当前位置:首页 » 行业动态 » 系统级封装SiP为何用陶瓷基板材料
系统级封装(SIP)技术是指将不同类型的元件通过不同的技术混载于同一封装之内,具有封装效率高、兼容性好、电性能好、低功耗和低噪音等优点。SIP技术要能满足集成微系统封装多样性的要求,需要采用陶瓷基板封装,那么这其中的缘由是什么呢?
SIP在核心基板(Core)上造出各元件连线层,各有源无源元件埋入层,光学系统层等;再在造好的基板上用倒装形式(Flip—Chip)或线焊(Wire—Bollding)方式安装上各个IC和MEMS,也包括不能埋入的无源元件和传感器。
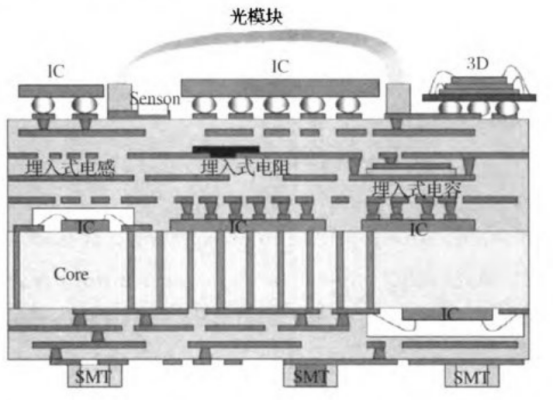
大部分灰色部分均由陶瓷材料组成
SIP涉及到多种材料(半导体材料、陶瓷材料、金属材料)、多种芯片、多种互连、多种封装(BGA、CSP、无源集成)、多种组装和多种测试等。其中,陶瓷基板材料是SIP的基础材料之一,对电路起到支撑和绝缘的作用。SIP需要实现高功率、高集成的需求。
只有制备出各项性能优异的封装材料,才能实现SIP多种封装结构、组装方式等。具体来说,SIP要求基板材料要求主要包括以下几个方面:
(1)低的介电常数;
(2)低介电损耗;
(3)高热导率;
(4)适宜的热膨胀系数;
(5)良好的力学性能;
绝大多数陶瓷基板材料一直沿用Al2O3和BeO陶瓷,但Al2O3基板的热导率低,热膨胀系数和Si不太匹配;BeO其较高的生产成本和剧毒的缺点限制了它的应用推广。此外,虽然AlN陶瓷的应用前景十分广阔,但还存在着成本高,高温下难致密烧结,生产中的重复性差等问题。未来电子封装材料将会朝着多相复合化的方向持续发展。

1、具有系列化性能的材料体系
SIP会涉及多种芯片、多种互连、多种封装等,因此必然要求其材料具有多种性能。比如,介电常数系列化;热膨胀系数系列化可以使得基板与多种芯片和封装结构匹配良好;收缩率系列化满足共烧等。因此,系列化的陶瓷材料能够很好地实现SIP对材料性能的多样化需求,
2、超高导热陶瓷材料的研究
为了实现系统的功能多样,SIP必然也与高导热材料有密不可分的关系。解决电子元器件的散热问题,热导率介于300~400W/m·K之间的高热导材料和热导率大于400W/m·K的超高热导材料,且具有与半导体材料相匹配的热膨胀系数的新型封装材料越来越成为目前的研究热点。
3、新型纳米陶瓷的开发
采用诸如溶胶-凝胶法、共沉淀法等纳米粉体的合成工艺制备的新型纳米陶瓷粉体具有很多传统陶瓷材料不具备的性能。例如,Si-AI-O-N材料可能就即具有AIN材料高导热的特性,又具有氮化硅的高强度和氧化硅的良好的介电性能;AI-B-N材料由于原子级的复合可能就比传统的AIN/BN复合材料具有更优异的导热性能而且烧结温度可能更低。因此,新型纳米陶瓷的开发将促进SIP技术的发展。
4、低维材料的开发
电子元器件小型化越来越高,传统三维材料甚至二维材料可能都不能满足要求,封装材料很有可能向一维材料(纤维或晶须)发展。例如,制备晶须或纤维复合陶瓷基板的一维材料,达到良好的散热作用。这些都对SIP的小型化和功能集成化起到革命性作用。
SIP技术能够很好地满足集成微系统封装多样性的要求。但是,首先需要从基础的基板材料进行相关的研究,实现材料性能的系列化和多样化,才能满足系统对封装的多样化需求。

通过公司研发团队的不懈努力,现已成功研发微小孔板、高精密板、难度板、微型化板、围坝板等,具备DPC、DBC、HTCC、LTCC等多种陶瓷生产技术,以便为更多需求的客户服务,开拓列广泛的市场。
© 2018 深圳市金瑞欣特种电路技术有限公司版权所有 技术支持:深度网