当前位置:首页 » 常见问题 » 基于pcb板的射频声表陶瓷滤波器封装技术研究
目前主流的终端用射频声表面波(RF-SAW)陶瓷滤波器均采用基于低温共烧陶瓷(LTCC)基板的倒装焊接技术,标准尺寸为单滤波器1.4mm×1.1mm,封装形式为芯片尺寸级封装(CSP)。介绍了一种基于印刷电路板(PCB)的CSP封装声表面波滤波器,其尺寸达到了1.4mm×1.1mm。使用该基板后,单个器件的材料成本将降低30%以上。通过优化基板的结构,可以达到与LiTaO3匹配的热膨胀系数(CTE)和较低的吸湿性。经后期的可靠性试验证明,该结构的射频陶瓷滤波器可完全满足工程应用的需求。

引言
随着各种新的封装技术的运用,声表面波(SAW)滤波器的封装尺寸不断减小;同时,由于智能手机的井喷式发展,射频声表面波(RF-SAW)器件的尺寸也不断缩小,目前的主流产品已达到单滤波器1.4mm×1.1mm,双工器2.0mm×1.6mm。特别是倒装焊接技术的引入,摒弃了传统的点焊线工艺,从而降低了器件的总厚度,也使整个封装从SMD级别进入了芯片尺寸封装(CSP)级别。不同厂家对于成本、工艺难度和可靠性等方面的控制水平高低不同,也使不同厂家采用不同的工艺路线。
随着移动终端市场的不断扩大,对于RF-SAW滤波器的需求也不断扩大,巨大的市场带来的激烈竞争使RF-SAW 滤波器的成本压力陡增。目前CSP封装的单滤波器售价已低于8美分,这也使降低成本成为RF-SAW 滤波器批量生产的重要题目。
1 印刷电路板(PCB)基板的材料特性及结构
降低成本需从原材料及工艺难度等方面考虑。采用一种基于双马来酰胺三嗪树脂[1]的印刷电路板进行RF-SAW 器件的生产,具有以下优点:
1)PCB板的价格低于陶瓷基板。陶瓷基板需要进行模具的设计和制作,且混料,流延,叠片及冲孔等工艺难度较大,陶瓷又具有收缩性,成品率低,导致陶瓷基板的价格高。PCB板的价格仅为陶瓷基板的1/3,且其工艺成熟,应用广,是优秀的基板
材料。
2)PCB板的研发成本远低于陶瓷基板[1]。由于1)中提到的各种原因,陶瓷基板很难进行优化改动,一次定型则无法更改。而PCB板因其灵活的布线能力,表面保护层的图形可定制性,使得针对PCB板的设计具有相当的灵活性,优化改动可很快
实现。模具费用仅为陶瓷基板的1/20。
3)PCB板在工艺上也有很多优势。因其不易碎裂,整个工艺流程中成品率高于陶瓷基板。如切割工序中,陶瓷由于易碎,易发生整片基板的裂片,严重影响成品率。
因此,使用PCB板代替陶瓷基板,是降低成本,快速适应市场需求的选择。
对于以钽酸锂(LiTaO3)等压电材料为衬底的SAW 器件,要使用CSP封装流程,必须考虑的一个素是热膨胀系数,这也是大多数CSP封装的RFSAW滤波器使用陶瓷基板的原因。表1为LiTaO3及陶瓷基板的热膨胀系数。

由表1可见,在基板材料与LiTaO3的热膨胀系数相差不大时,通过焊球在一定程度上进行柔性连接,可解决因热膨胀系数差别过大而导致的热失配情况,降低失效率。
沿着这一思路,在选择PCB板时,我们特别注意在通用的基板材料中选择热膨胀系数与LiTaO3接近或与陶瓷接近的品种,这样就可在热匹配方面做到替代。图1为CSP封装用PCB板详细结构。

图1 PCB基板的基本结构
随着有机材料工业的不断发展,使我们在热膨胀系数方面有了很多选择。根据LiTaO3的特性,参考陶瓷材料的热膨胀系数[1],如表2所示。

表2有机基板材料选择
2 应用PCB板的射频声表滤波器CSP封装
器件的整体结构与目前主流的CSP结构完全一致,如图2所示。

图2 使用倒装焊接工艺的SAW 滤波器标准结构
整个CSP封装的RF-SAW 滤波器由以下几部分组成:
1)树脂膜。一种主要成分为环氧树脂的膜,可起到包裹密封的作用。
2)带球的声表芯片。芯片上的球可为锡球也可为金球,成球的工艺不同,并对后期的工艺有一些影响。本文中,我们设定此球为金球,采用热压超声的方法植球于芯片的表面。
3)基板。在整个结构中起到物理支撑和电路连接的作用。
RF-SAW 滤波器的CSP封装基本流程中,晶圆植球和切割不再详述,这里只针对倒装焊接开始的流程进行讨论,如图3所示。

图3PCB基板倒装焊器件封装流程
利用热压超声焊接工艺将植好的金球且切割好的芯片倒装在有机基板上;树脂膜通过热压的方式压合在基板上,同时对器件进行包裹封装;最后在利用砂轮划片机将器件切割分离,形成最终的产品。通过上面的选择,我们找到了对应的PCB板作为CSP封装的基板,在倒装焊接工艺上,我们也做了倒装焊接参数详细的对比(八焊球,每个焊球直径80μm),如表3所示。由表可见,陶瓷基板的焊接参数[2]完全适用于PCB基板,即在焊接工艺上两种基板的焊接参数无区别。图4为两种不同基板间芯片剪切力的对比。

表3 倒装焊接参数对比

图4 芯片剪切力测试数据图
根据计算,具有8颗焊球的倒装芯片,其剪切力超过300g(理论计算值),则可判定为合格。所以,陶瓷基板与PCB基板间,在剪切力方面无任何区别,即PCB基板上的倒装芯片剪切力稍好。
3 PCB基板的CSP封装器件验证
我们使用同一晶圆上的芯片分别使用陶瓷基板和树脂基板进行相同的倒装焊接和贴膜封装,然后进入测试(见图5)。RF-SAW 样品器件中心频率为1842MHz,带宽为100MHz,芯片及器件尺寸分别为0.95mm×0.65mm和1.4mm×1.1mm,测试环境:无匹配测试。
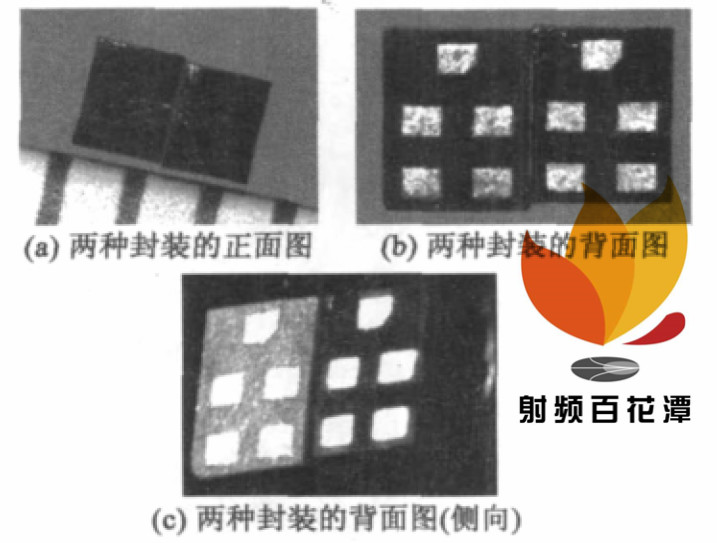
图5 RF-SAW CSP陶瓷基板和树脂基板
通过对比可确认,在晶圆一致的情况下,使用陶瓷基板和使用PCB基板的器件在性能上接近。图6为器件测试对比图。在所有的可靠性测试中,重要的是热冲击实验热冲击实验是将考验器件在短时间内从极低温到高温或从高温到极低温时,热应力积聚和释放的过程,如果在这些试验中出现了问题,则表明器件中热应力积聚过大,器件的机械稳定性不好。考虑器件结构,我们参照GJB548A-2006温度循环及鉴定
和质量一致性检验程序,选择试验方法1010A的条件B和200次循环。针对倒装焊接的CSP器件来说,此实验主要考察其内部腔体的膨胀力与焊球拉力的大小,如果器件失效,则表明内部腔体的膨胀力大于焊球的垂直拉力,则器件判为不合格[3]。
稳态湿热试验主要考察树脂封装器件的耐湿性能,通过高温、高湿条件可构成水汽吸附、吸收和扩散等作用,验证PCB基板及其材料在吸湿后膨胀性能满足度,参照GJB360-96稳态湿热试验103方法的条件A。如果发生吸潮,器件的物理机械性能会有较大变化,器件的幅频特性会发生巨大改变[4]。
将使用PCB基板生产的SAW CSP器件共230只进行相同的试验,陶瓷基板的器件均能通过可靠性试验,详细情况如表4所示。(即温度循环实验)[2]和稳态湿热试验(即潮热试验)[2]。

图6 器件测试对比图
热冲击实验是将考验器件在短时间内从极低温到高温或从高温到极低温时,热应力积聚和释放的过程,如果在这些试验中出现了问题,则表明器件中热应力积聚过大,器件的机械稳定性不好。考虑器件结构,我们参照GJB548A-2006温度循环及鉴定
和质量一致性检验程序,选择试验方法1010A的条件B和200次循环。针对倒装焊接的CSP器件来说,此实验主要考察其内部腔体的膨胀力与焊球拉力的大小,如果器件失效,则表明内部腔体的膨胀力大于焊球的垂直拉力,则器件判为不合格[3]。
稳态湿热试验主要考察树脂封装器件的耐湿性能,通过高温、高湿条件可构成水汽吸附、吸收和扩散等作用,验证PCB基板及其材料在吸湿后膨胀性能满足度,参照GJB360-96稳态湿热试验103方法的条件A。如果发生吸潮,器件的物理机械性能会有较大变化,器件的幅频特性会发生巨大改变[4]。
将使用PCB基板生产的SAW CSP器件共230只进行相同的试验,陶瓷基板的器件均能通过可靠性试验,详细情况如表4所示。

表4 PCB基板CSP可靠性试验
完成可靠性实验后,我们对器件进行了解剖分析和确认(见图7),树脂基板在整个过程中没有发生任何变化。最后,所有的器件都通过了测试。

图7 两种封装外壳的解剖分析
4 结束语
一种基于双马来酰胺三嗪树脂BT树脂的基板pcb板应用于SAW 滤波器的CSP封装中,从而替代陶瓷基板,在批量生产中将带来30%以上的成本降低。通过后期的性能测试和可靠性试验,验证了该基板能适应RF-SAW CSP封装的需要。在综合考虑贴膜封装等其他工艺参数的微调后,该多层pcb板能使用在今后的SAW 批量生产中。(参考文献略来源:射频百花谭 )

通过公司研发团队的不懈努力,现已成功研发微小孔板、高精密板、难度板、微型化板、围坝板等,具备DPC、DBC、HTCC、LTCC等多种陶瓷生产技术,以便为更多需求的客户服务,开拓列广泛的市场。
© 2018 深圳市金瑞欣特种电路技术有限公司版权所有 技术支持:深度网