当前位置:首页 » 常见问题 » 氧化铝陶瓷高温银浆表面金属化研究
电子银浆料是通过丝网印刷工艺预先均匀分布在氧化铝陶瓷板表面。笔者通过四探针测试法和背散射电子成像分别研究了烧结保温时间和基板腐蚀情况对银金属化层的形貌、表面电阻率以及机械特性的影响。实验数据显示, 在850℃保温40min时银金属化层的表面电阻率最小且有最大的附着力强度。此外, 即使在氧化铝陶瓷基板被不同浓度的氢氧化钠碱液腐蚀后, 银金属化层仍然具有较小的表面电阻率和较大的附着力强度。基于实验结果可得出, 在银金属化层与氧化铝陶瓷基板界面处提出了银金属化层网状结构和玻璃的网状结构相互交错的模型。
经过表面金属化的陶瓷广泛应用在电池、集成电路、切削工具, 特别是能源行业[1]。因此, 近几十年陶瓷科研工作者已为实现陶瓷的表面金属化做出了突出的贡献。在这些金属化工艺中, 丝网印刷银厚膜金属化工艺因其简便和廉价成为应用广泛的工艺方法之一。
通常, 采用丝网印刷的陶瓷表面金属化可以通过玻璃相迁移过程实现[4]。在金属和陶瓷界面处玻璃相的形成促进了金属化过程中的化学键合。因此对高附着力而言, 研发连续的玻璃相是必需的, 因为除了不同相之间的化学键合外玻璃相还提供了机械键合[。
氧化铝是一种应用在大功率器件、电路和模块中的理想的基板和封装材料[6]。所附着的银厚膜的金属化通常采用丝网印刷工艺得到, 而且在此工艺中, 包含银粉, 玻璃粉和一些有机溶剂的银浆是在空气气氛下烧结的。在烧结过程中, 银浆中的玻璃粉在连接层形成过程中起到了关键的作用。另外, 银浆的组成、烧结保温时间和基板表面腐蚀情况等决定了丝网印刷后的银连接层的电学特性。
笔者主要研究了烧结时间和基板腐蚀对银金属化层的烧结过程、连接层的形成、表面电阻率 (ρs) 和附着力的影响, 所得到的微观形貌是按照烧结时间和氢氧化钠浓度进行分组的。此外, 氧化铝陶瓷板上的银金属化层的ρs和附着力, 也就是分别反映了银金属化层的电学和力学特性, 对此也进行了测试和比较。最终, 基于实验结果提出了简单的热动力学模型以描述连接层的形成过程。
1.1 氧化铝陶瓷基板和银浆
选取的商用陶瓷基板 (成分为95%Al2O3, 5%MgO、SiO2和CaO) 尺寸为20mm×20mm×1mm。这些基板均使用丙酮和去离子水通过超声波清洗仪进行表面预处理。丝网印刷工艺选取的厚膜材料是上海宝银有限责任公司生产的高温银浆 (含银原料65%, 玻璃粉5%, 有机载体30%) 。
1.2 制备银金属化层
烧结银金属化层前, 陶瓷基板两侧的银浆均通过孔径为200目的丝网, 印刷成直径为15mm, 厚度为0.8mm的样品, 然后在120℃下烘干10min, 定型, 并在850℃下烧结, 保温时间分别是20min、40min、60min。
一,实验
为了进一步探究基板腐蚀对金属化的影响, 陶瓷基板分别用10%、20%、30%的氢氧化钠浓度进行腐蚀。腐蚀后的基板均印刷上相同的银浆, 烧结保温时间均为40min。
1.3 银金属化层的表征
采用背散射电子成像技术 (SEM-BSI:FEI Qunanta 200FEG) 研究金属化层的微观形貌。通过四探针电阻率测试仪 (型号:KDY-1, 广州市昆德科技有限公司生产) 利用四探针法试其ρs。图1为四探针测试法示意图, 探针间距为1mm。其工作原理如下:当1、2、3、4这4根金属探针排列成一条直线, 并以一定压力压在半导体材料之上时, 探针1和4间通过电流I, 则在探针2和3探针间产生电位差V。

式中:C为探针修正系数, 由探针间距决定。

式中:S1, S2, S3分别为探针1与2, 2与3, 3与4之间的距离。
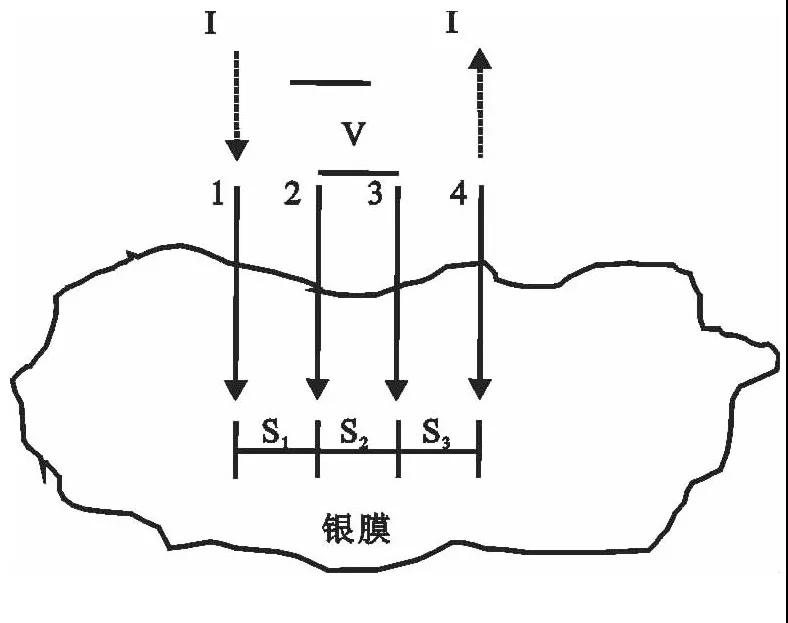
图1 四探针测试原理示意图
探针1和4通过电流, 探针2和3间产生电压。通过拉力强度试验机 (型号:AI-7000-LA, 高铁检测仪器公司生产) 分析银金属化层的机械特性。图2是待测样品拉力测试示意图。附着力强度通过公式 (3) 运算得出:

式中:X———银金属化层断裂时的附着力强度, MPa;
F———断裂时的最大拉力, N;
d———断裂面的直径, mm。
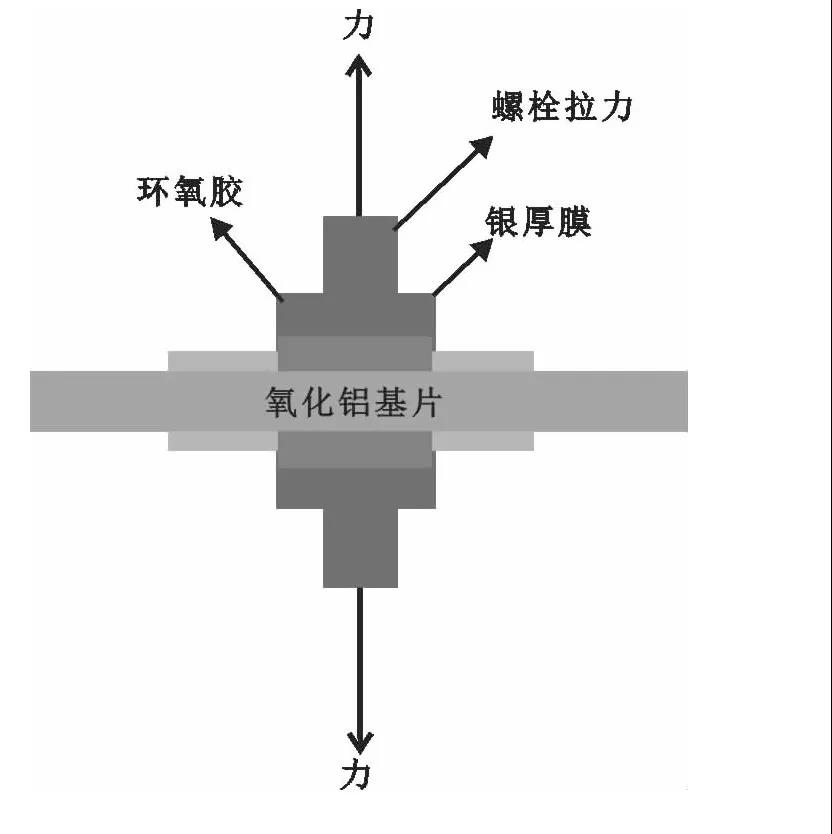
图2 待测样品附着力测试示意图
1.4 韦伯分布
通过韦伯分布静态分析银金属化层的表面电阻率和附着力强度, 并采用公式 (1) 和 (2) [17]进行详细描述:

其中:β———形状参数;
η———尺度参数;
P———ρs和附着力强度出现的概率值;
M———ρs和附着里强度的平均值;
M0———概率值为零时的ρs和附着力强度。
2组实验数据均按照概率值P的大小和相应序号

式中:N———样品尺寸;
按照公式 (4) 和 (5) 拟合实验数据, ln (ln (1/ (1-P) ) ) 与ln (ρsi) 和ln (Xi) 相关性分别如图4~图7、图9~图11所示。由拟合线的斜率和截距可得形状参数和尺度参数。ρs和附着力强度的平均值以及双参数的韦伯分布的标准偏差分别通过公式 (6) 和 (7) 可知:

其中, Γ (1+1/β) 是由伽马函数通过 (1+1/β) 的值计算所得。
2.1 烧结保温时间对银金属化层表面电阻率和附着力强的影响
通过BSE表征分析了不同烧结时间的银金属化层的微观形貌。图3 (a) 是850℃保温20min的银金属化层横断面的微观形貌, 银金属化层的不连续, 说明了银浆中玻璃粉体未完全融化。银浆中的玻璃粉可以防止银金属化层的过度收缩, 进而影响银金属化层的ρs和附着力强度。
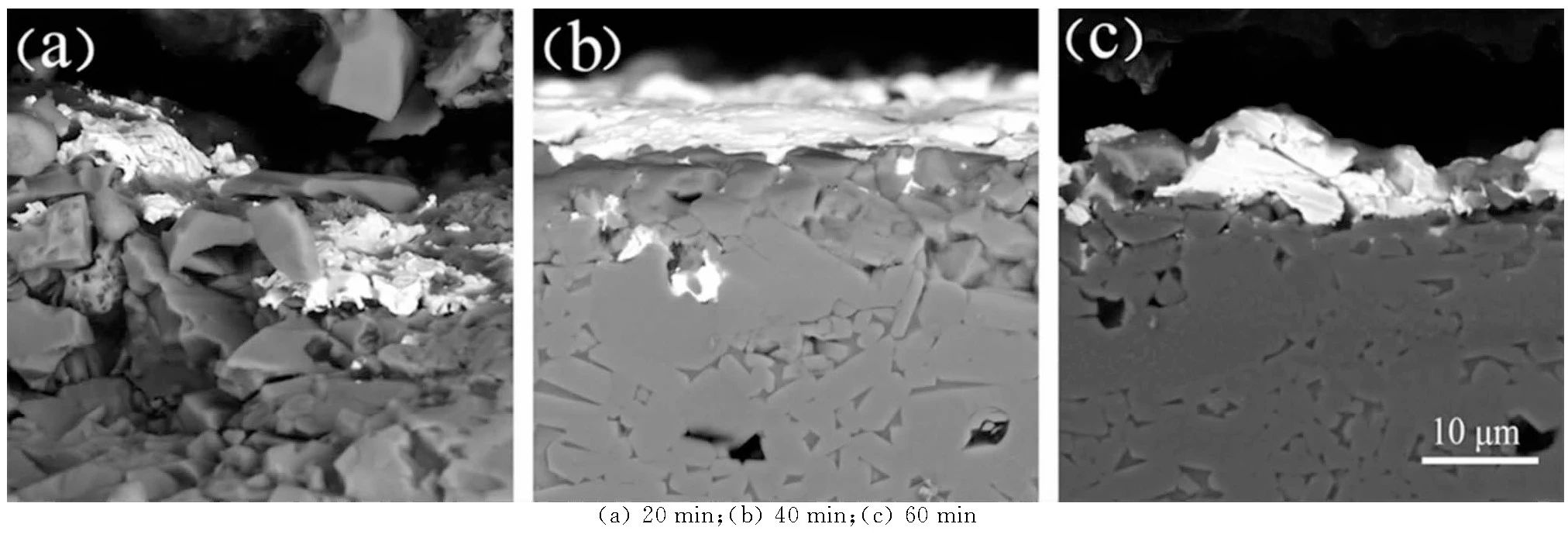
图3 在850℃下不同保温时间烧结的银膜与氧化铝基板间的界面断口照片、背散射电子照片
图3 (b) 是850℃保温40min的银金属化层形貌, 有较好的界面润湿特性;同时也显示出在银金属化层和基板之间有明显的连接层, 进一步表明银金属化层与陶瓷基板之间存在一种非晶的玻璃相, 可能是由银浆中的玻璃相与陶瓷基板中玻璃相共同构成。陶瓷基板中的亮点进一步证明银颗粒已经在熔融玻璃体的帮助下扩散到了基板内。
图3 (c) 是850℃保温60min的银金属化层断面形貌, 其银金属化层厚度接近10μm, 其中灰黑区域证明玻璃相的存在, 进而导致了银金属化层的较高的ρs, 然而银金属化层中的微裂纹缺陷中降低了银金属化层的附着力强度。
图4和图6所表示银金属化层的ρs和附着力强度韦伯分布, 由β的值大于1可知所测得的两者的实验数据, 可信度较高。所有的分布曲线显示出相对较好的线性, 说明每个数据点的散射分布均符合双参数的韦伯分布函数。
图4为不同保温时间下银膜的ρs按照韦伯函数的平面分布图, 图5为平均ρs随烧结保温时间的变化趋势图 (误差棒为标准误差值) 。

图4 不同保温时间下银膜的ρs按照韦伯函数的平面分布图
图5和图7分别是银金属化层的ρs和附着力强度随烧结保温时间的函数变化趋势图。随烧结保温时间的增加, 银金属化层的ρs先降后升, ρs最小值为2.11×10-7 (Ω·cm) 。而图6显示出随烧结保温时间的增加附着力强度则是先升后降。此外, 在所有的拉伸测试中, 失效处均在环氧胶, 银金属化层与陶瓷基板之间。部分银金属化层在外力作用下脱离了基板, 其脱离基板时的附着力强度如图7所示。

图5 平均ρs随烧结保温时间的变化趋势图
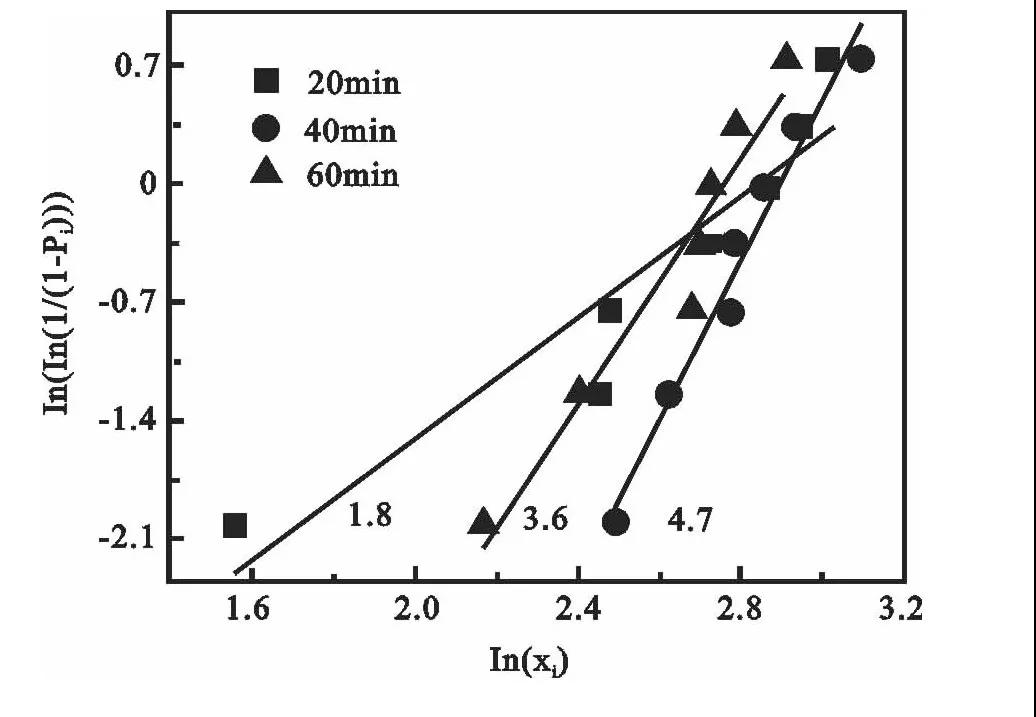
图6 不同保温时间下银膜的附着力强度按照韦伯函数的平面分布图

图7 平均附着力随烧结保温时间的变化趋势图
2.2 基板腐蚀对银金属化层的表面电阻率和附着力强度的影响
为了进一步探究基板腐蚀对银金属化层形成的影响, 分别选取了不同浓度的氢氧化钠碱液腐蚀陶瓷基板表面。图8为银金属化层与腐蚀后的基板间断面形貌, 随着碱液浓度的增加, 银金属化层的厚度减小而银金属化层的连续性越来越好。
图9和图11分别为银金属化层的表面电阻率和附着力强度的韦伯分布函数图。
由图10和图12可知, 随着氢氧化钠浓度的提高, 陶瓷基板的受腐蚀程度随之增加, ρs在明显减小而附着力强度一直在增加。ρs是对电流通过材料表面时阻抗电流流动的量化呈现, 而且不仅和材料的物理尺寸[19]有关, 更依赖于材料表面的组成。
银浆中的玻璃粉体与陶瓷中的玻璃相在银金属化层与基板间形成了一种夹层结构, 增强了银金属化层与基板间的化学键合和物理润湿性, 进而提高了附着力强度, 其值从18.33MPa增大至20.67MPa。在陶瓷基板一侧, 银金属化层烧结完成后, 陶瓷晶粒极有可能已经浸润在玻璃连接层中。随着腐蚀基板程度的增加, 浸润的程度也随之增强。
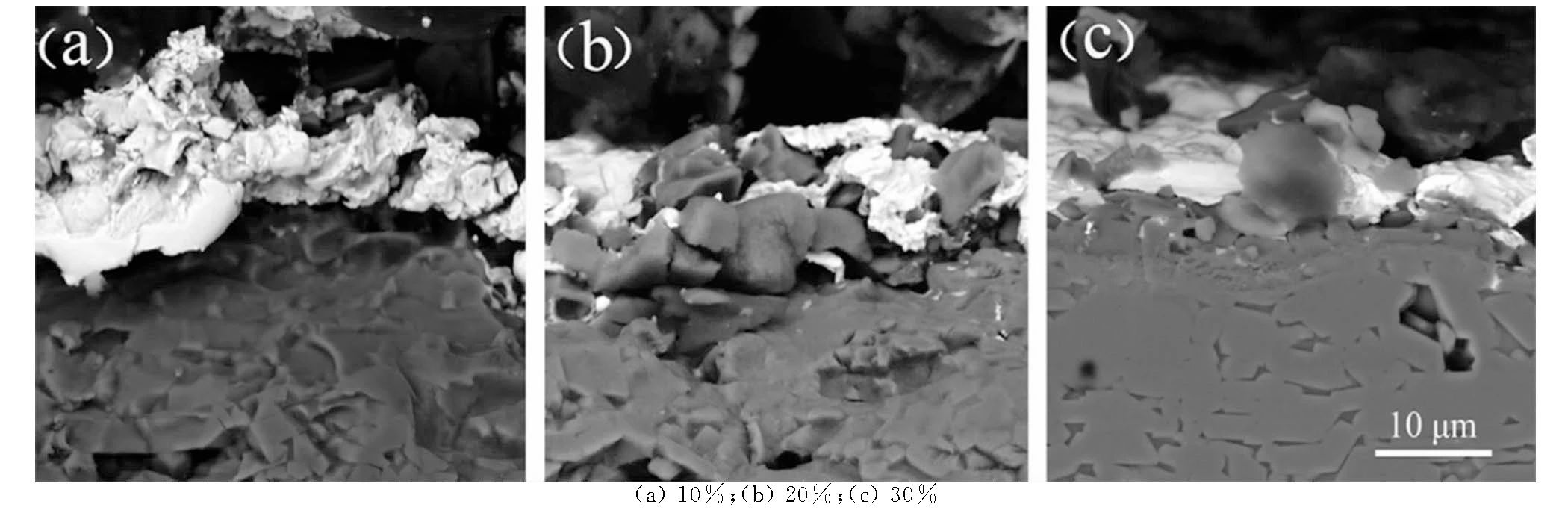
图8 银膜与不同氢氧化钠腐蚀浓度下的氧化铝基板间的界面断口照片背散射电子照片
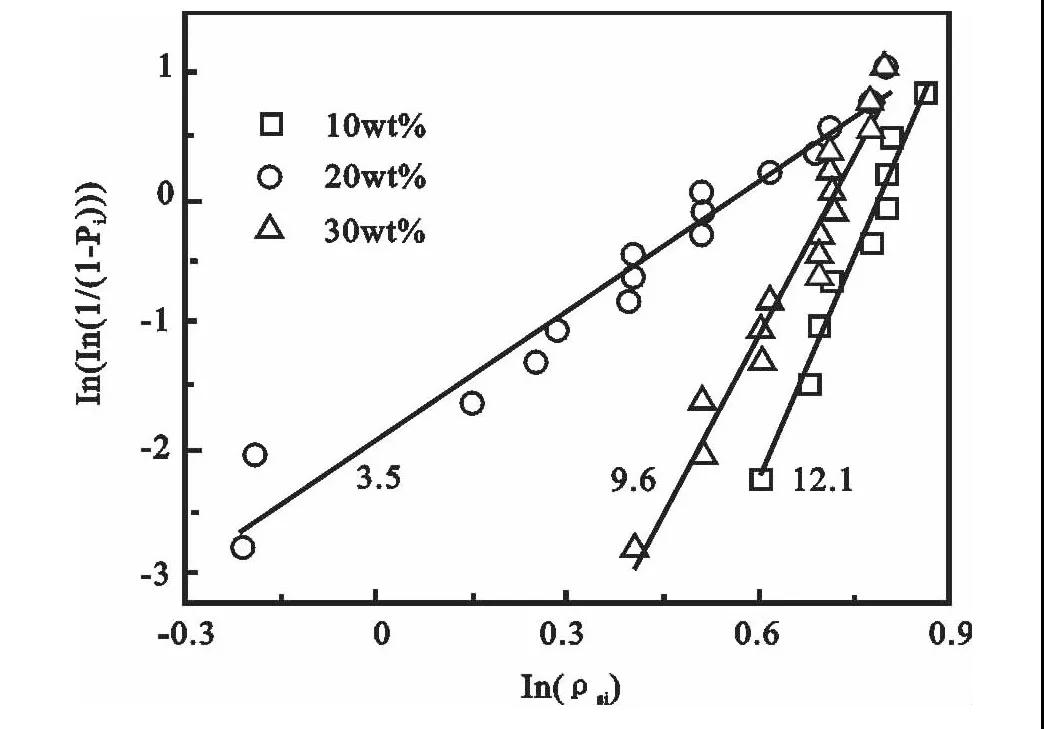
图9 不同氢氧化钠腐蚀浓度下银膜的ρs按照韦伯函数的平面分布图

图10 平均ρs随氢氧化钠腐蚀浓度的变化趋势图 (误差棒为标准误差值

图11 不同氢氧化钠腐蚀浓度下银膜的附着力按照韦伯函数的平面分布图

图12 平均附着力随氢氧化钠腐蚀浓度的变化趋势图
2.3 银金属化层与陶瓷基板界面处连接层形成机理
图13为银金属化层与陶瓷基板间的连接体模型。银浆钢丝网印刷上陶瓷基板后, 银粉和玻璃粉体是随机分布 (如图13 (a) 所示) 。伴随烧结温度超过玻璃粉体的软化温度, 玻璃粉体变成液态携带着银粉流动并润湿填充在陶瓷基板上的微裂纹间隙 (如图13 (b) 所示) 。
随后的冷却过程中, 银金属化层逐渐形成 (如图13 (c) 所示) 。因为在流动的玻璃体中银离子分散速度高于银原子[20], 烧结过程中形成了稳定的内嵌网状银的玻璃网络结构 (如图13 (d) 所示) 。两种网络结构间的化学和物理键合增强了连接层[21], 产生了较低的ρs和较高的附着力强度。陶瓷基板表面, 晶粒间被浸润在一层玻璃相中[22] (如图13 (e) 所示) 。在连接层区域, 填充的玻璃相起到了非常关键的作用, 增加了对陶瓷基板的腐蚀程度, 提高了玻璃相的润湿性, 进而增强了附着力强度。
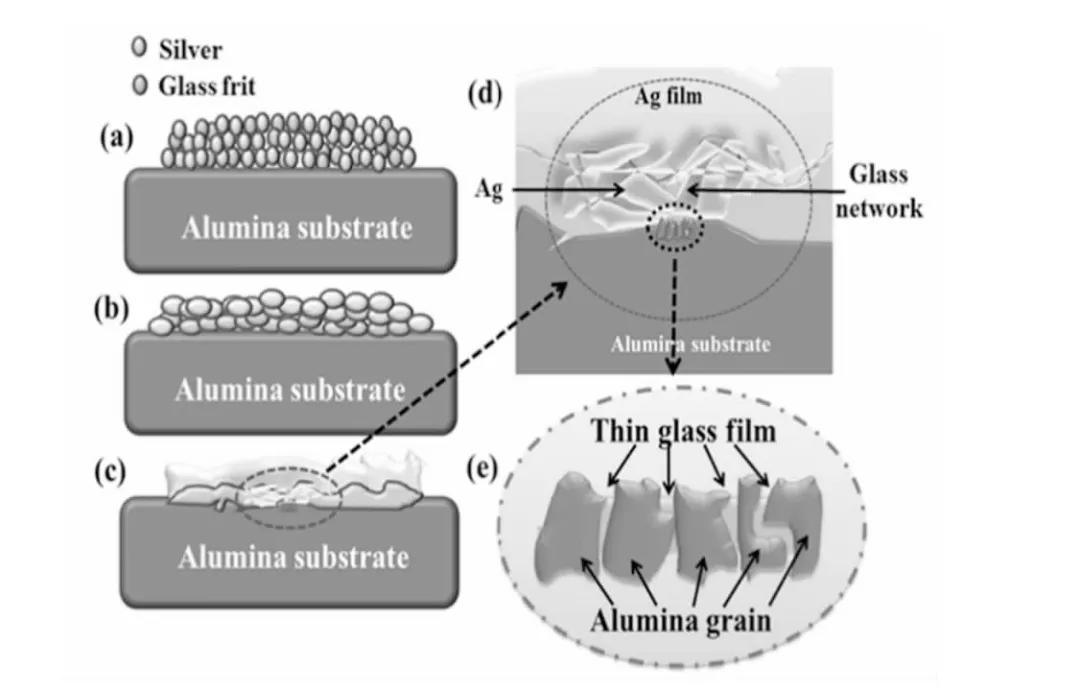
图13 银膜与氧化铝基板间连接体形成机理示意图
(a) 烘干成形后银粉与玻璃粉随机分布在基板表面; (b) 银粉间开始集聚且玻璃粉开始软化; (c) 银膜与玻璃膜分别形成网络连接体; (d) 内嵌银的玻璃相网络结构连接体; (e) 玻璃相浸润氧化铝晶粒
不同的烧结保温时间和基板腐蚀程度影响了玻璃相的浸润性和内嵌网状银的玻璃网状结构的形成, 进而影响了银金属化层的ρs和附着力强度。
三,结论
研究了烧结时间和基板腐蚀情况对氧化铝陶瓷银金属化的影响:
1) 在烧结温度为850℃, 保温40min时, 银金属化层的表面电阻率最低, 附着力强度最大;
2) 陶瓷基板的腐蚀程度会显著影响氧化铝陶瓷银金属化效果;
3) 基于实验数据, 提出了表面金属化过程中连接层形成的模型;
4) 部分银离子在流动玻璃体的帮助下迁移至氧化铝陶瓷基板内。
烧结速率和机理除了受烧结气氛、温度、保温时间和表面张力等变量决定外, 还与粉体粒径分布、颗粒比表面、填充效率、玻璃粉粘度等变量有密切关系。
数据来源:《陶瓷》,2014,(05),17-23

通过公司研发团队的不懈努力,现已成功研发微小孔板、高精密板、难度板、微型化板、围坝板等,具备DPC、DBC、HTCC、LTCC等多种陶瓷生产技术,以便为更多需求的客户服务,开拓列广泛的市场。
© 2018 深圳市金瑞欣特种电路技术有限公司版权所有 技术支持:深度网